
Wire Bonding
Si-Craft Technologies provides comprehensive wire bonding solutions optimized for reliability, fine-pitch performance, and process flexibility. Our bonding services support Au, Cu, and Al wires as well as Au ribbon interconnects, enabling high-quality connections across a wide range of semiconductor and optoelectronic packages.
Au Ball Bonding (Thermosonic Bonding)
Si-Craft's uses a thermosonic process where a free air ball (FAB) is formed by electronic flame-off and bonded to the die pad through controlled ultrasonic energy, pressure, and heat. This method provides strong, reliable interconnects and is ideal for fine-pitch, high-density packages. Si-Craft’s capabilities cover wire diameters from 15–50 µm, with bond pitch down to 35 µm and operating temperatures between 150–200 °C. Compatible pad finishes include Al, Ni/Au, NiPdAu, and Cu, supporting a wide range of applications such as logic ICs, analog devices, memory, and RF modules. Known for excellent bondability, process stability, and proven reliability, Au ball bonding remains a key process in Si-Craft’s advanced packaging lineup.
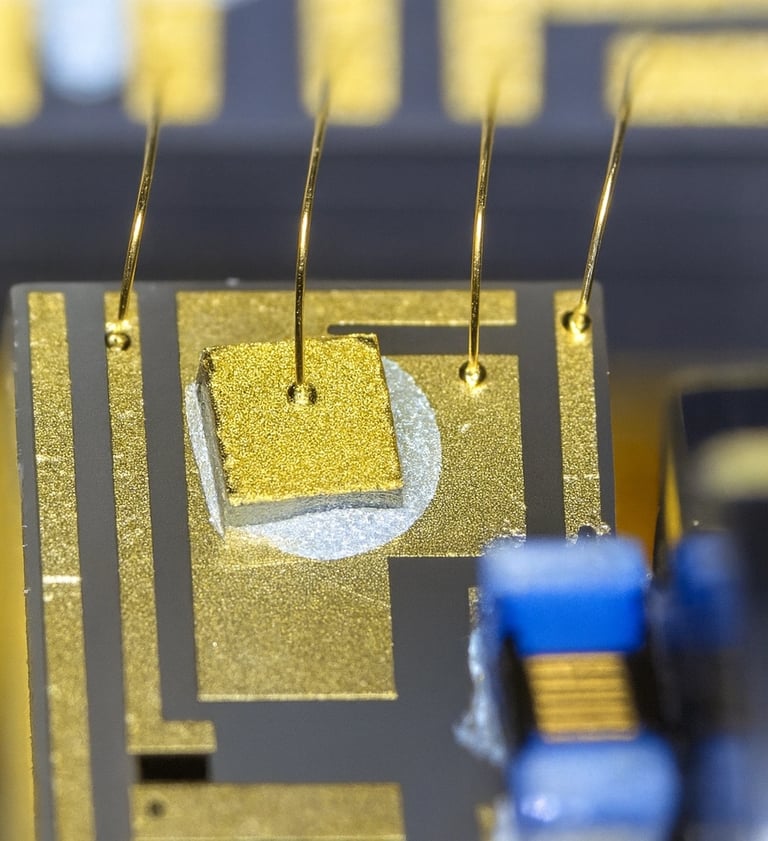
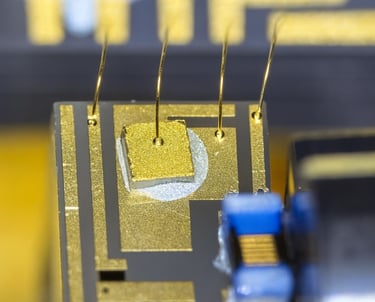
Cu Ball Bonding
Cu Ball Bonding provides superior electrical and thermal conductivity at a significantly lower cost than gold, making it ideal for high-power and high-volume production. Using a thermosonic process similar to gold bonding, copper requires strict process control to manage oxidation, which can degrade bond strength and reliability. To prevent this, Si-Craft operates under inert or forming gas environments and maintains precise capillary temperature regulation during free air ball formation. Our process supports wire diameters from 15–35 µm, with fine loop height control below 70 µm and optimized parameters for consistent interconnect integrity. Compatible with Cu, NiPdAu, and bare Al pads, Cu ball bonding offers excellent conductivity, strong mechanical adhesion, and a cost-effective alternative for advanced packaging applications.


Al Wedge Bonding (Ultrasonic / Thermosonic)
Al Wedge Bonding utilizes ultrasonic energy and mechanical pressure—often with minimal or no heat—to form robust interconnects using aluminum wire or ribbon. This process is especially suited for power, hybrid, and RF devices where aluminum metallization is common and temperature sensitivity is a concern. Si-Craft’s capabilities cover wire diameters from 25–100 µm and ribbon dimensions around 0.5 × 0.1 mm, operating effectively between room temperature and 150 °C. The method delivers strong metallurgical bonds with excellent mechanical reliability and low contact resistance. Its low thermal input and compatibility with Al–Si and Al–Cu pad finishes make it ideal for applications demanding high reliability, stable performance, and minimal thermal stress on sensitive components.


Al/Au Ribbon Bonding
Al Ribbon Bonding employs a flat aluminum/au strip instead of round wire to achieve low inductance and high current-carrying capability, making it ideal for power modules, RF, and microwave devices. Using ultrasonic or thermosonic wedge bonding, this process creates wide, stable interconnects that efficiently dissipate heat and minimize electrical losses. Si-Craft’s process supports ribbon widths from 25–250 µm and thicknesses between 10–50 µm, allowing precise control of bond geometry and loop profile. The aluminum ribbon forms reliable metallurgical bonds with Al–Si and Al–Cu pad finishes, offering superior mechanical strength and consistent performance in high-current or high-frequency environments where conventional wire bonds may be insufficient.


